堆叠芯片技术是什么意思,技术原理介绍
发布时间:2023-09-07 14:30:29 来源:96845 编 辑:9万精品
|
堆叠(Stacked) 是另外一种常见的多晶片封装技术;它是将个别晶片封装完成后再进行堆叠的动作(Multi-stacked Package Technology),因此与多颗裸晶片堆叠的MCP封装不同,如(下图)即是先完成导线架(Lead-frame)型式或BGA型式的封装后再进行堆叠。
这样的优点在于可以在个别的IC封装完成后先进行测试,并只将通过测试的封装进行堆叠,以解决无法取得良好裸晶的问题。目前这种封装方式的研究方向在于使堆叠后的厚度可以减小。
下图为Toshiba开发中的立体堆叠之薄型化封装(3-D Paper-thin Package,PTP),为了要达到Toshiba所定义的薄型化封装,因此在未堆叠前的IC封装厚度就需小于0.2mm,所以晶片需进行磨薄的超薄化晶圆制程(Ultra-Thin Wafer Processing),基板也需采用薄型化基板如Tape型式的基板或新式的无核心层(Core layer)基板等,而晶片与基板连接也应使用低高度(Low Profile)方式如以覆晶式无凸块(Flip-chip Bumpless)连接方式,这些技术都将是未来发展薄型化堆叠封装的关键所在。
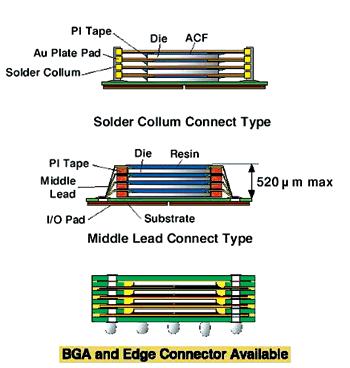 |